Кремний карбиди менен таанышуу
Кремний карбиди (SiC) – көмүртек жана кремнийден турган татаал жарым өткөргүч материал, ал жогорку температура, жогорку жыштык, жогорку кубаттуулук жана жогорку чыңалуудагы түзүлүштөрдү жасоо үчүн идеалдуу материалдардын бири. Салттуу кремний материалы (Si) менен салыштырганда, кремний карбидинин тилкеси кремнийдикинен 3 эсе көп. жылуулук өткөрүмдүүлүк кремнийдикинен 4-5 эсе көп; Бузулуу чыңалуу кремнийдикинен 8-10 эсе көп; Электрондук каныккан дрейфтин ылдамдыгы кремнийдикинен 2-3 эсе көп, ал заманбап өнөр жайдын жогорку кубаттуулукка, жогорку чыңалууга жана жогорку жыштыкка болгон муктаждыктарына жооп берет. Ал негизинен жогорку ылдамдыктагы, жогорку жыштыктагы, кубаттуу жана жарык берүүчү электрондук компоненттерди өндүрүү үчүн колдонулат. Төмөнкү колдонуу талааларына акылдуу тармак, жаңы энергетикалык унаалар, фотоэлектрдик шамал энергиясы, 5G байланышы ж.б. кирет. Кремний карбид диоддору жана MOSFETтер коммерциялык түрдө колдонулган.

Жогорку температурага каршылык. Кремний карбидинин тилкесинин кеңдиги кремнийдикинен 2-3 эсе көп, электрондор жогорку температурада өтүү оңой эмес жана жогорку иштөө температурасына туруштук бере алат, ал эми кремний карбидинин жылуулук өткөргүчтүгү кремнийден 4-5 эсе жогору, аппараттын жылуулуктун таралышын жеңилдетет жана чектүү иштөө температурасы жогору. Жогорку температурага туруштук берүү муздатуу системасына талаптарды азайтып, терминалды жеңилирээк жана кичирээк кылып, кубаттуулуктун тыгыздыгын бир топ жогорулата алат.
Жогорку басымга туруштук берүү. Кремний карбидинин бузулуу электр талаасынын күчү кремнийдикинен 10 эсе жогору, ал жогорку чыңалууга туруштук бере алат жана жогорку вольттуу түзүлүштөр үчүн ылайыктуу.
Жогорку жыштык каршылык. Кремний карбидинин каныккан электрон дрейф ылдамдыгы кремнийге караганда эки эсе жогору, натыйжада өчүрүү процессинде токтун калдыктары жок болот, бул аппараттын которуштуруу жыштыгын натыйжалуу жакшыртат жана аппаратты кичирейтүүнү ишке ашырат.
Төмөн энергия жоготуу. Кремний материалы менен салыштырганда, кремний карбиди өтө төмөн каршылыкка жана аз жоготууга ээ. Ошол эле учурда, кремний карбидинин жогорку тилкесинин туурасы агып кетүү агымын жана электр энергиясын жоготууну кыйла азайтат. Мындан тышкары, кремний карбид аппарат өчүрүү учурунда учурдагы арткы көрүнүш жок, жана которуу жоготуу төмөн.
Кремний карбидинин өнөр жай чынжыр
Ал негизинен субстрат, эпитаксия, аппараттын дизайны, өндүрүш, пломба жана башкалар кирет. Кремний карбиди материалдан жарым өткөргүчтүн кубаттуулугуна чейин бир кристаллдын өсүшүн, куймаларды кесүүнү, эпитаксиалдык өсүштү, пластинанын дизайнын, өндүрүштү, таңгактоону жана башка процесстерди башынан өткөрөт. Кремний карбиди порошок синтездегенден кийин алгач кремний карбидинин куймасы жасалат, андан кийин кесүү, майдалоо жана жылмалоо жолу менен кремний карбидинин субстраты, ал эми эпитаксиалдык барак эпитаксиалдык өсүү жолу менен алынат. Эпитаксиалдык пластинка кремний карбидинен литография, оюу, иондук имплантация, металлды пассивациялоо жана башка процесстер аркылуу жасалат, пластина штампка кесилип, аппарат таңгакталып, аппарат атайын кабыкчага бириктирилип, модулга чогултулат.
Өнөр жай чынжырынын өйдө агымы 1: субстрат - кристаллдын өсүшү процесстин негизги звеносу
Кремний карбид субстрат кремний карбид аппараттардын наркынын болжол менен 47% түзөт, жогорку өндүрүштүк техникалык тоскоолдуктар, ири баалуулук, SiC келечектеги масштабдуу өнөр жайлык өзөгү болуп саналат.
электрохимиялык касиеттери айырмачылыктар көз карашынан алганда, кремний карбид субстрат материалдар өткөргүч субстраттарга бөлүүгө болот (каршылыгы аймак 15 ~ 30mΩ · см) жана жарым изоляцияланган субстраттарга (каршылыгы 105Ω · см жогору). Бул эки түрдөгү субстрат эпитаксиалдык өсүштөн кийин, тиешелүүлүгүнө жараша электр аппараттары жана радио жыштык түзмөктөрү сыяктуу дискреттик түзүлүштөрдү өндүрүү үчүн колдонулат. Алардын ичинен жарым изоляцияланган кремний карбиддик субстрат негизинен галлий нитридинин RF приборлорун, фотоэлектрдик приборлорду жана башкаларды жасоодо колдонулат. Жарым изоляцияланган SIC субстратында ган эпитаксиалдык катмарын өстүрүү менен, sic эпитаксиалдык плитасы даярдалат, аны андан ары HEMT gan изо-нитриддик RF түзүлүштөрүнө даярдоого болот. Өткөргүч кремний карбиддик субстрат негизинен электр приборлорун өндүрүүдө колдонулат. салттуу кремний электр аппаратты өндүрүү жараяны айырмаланып, кремний карбид күч аппарат кремний карбид субстрат боюнча түздөн-түз жасалган болушу мүмкүн эмес, кремний карбид epitaxial катмар кремний карбид epitaxial баракты алуу үчүн өткөргүч субстрат боюнча өстүрүлгөн керек, жана epitaxial катмары Schott BT ETF жана башка түзмөктөр боюнча өндүрүлгөн, Schotde BT .
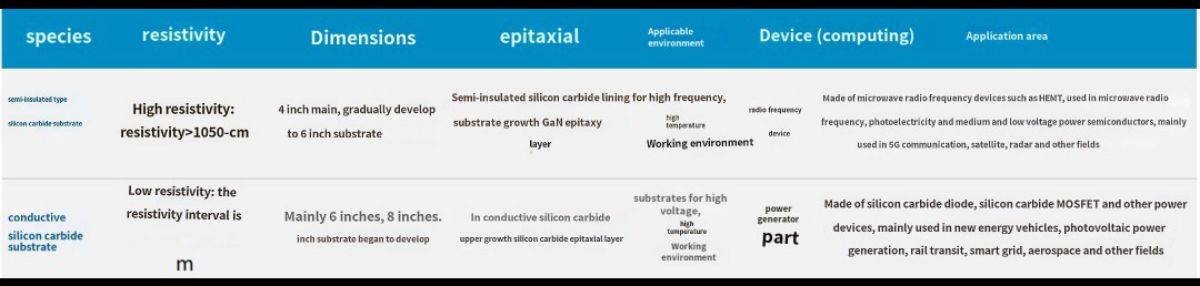
Кремний карбид порошок жогорку тазалыктагы көмүртек порошок жана жогорку тазалыктагы кремний порошок синтезделген, жана кремний карбид куймасынын ар кандай өлчөмдөгү атайын температура талаасында өстүрүлгөн, андан кийин кремний карбид субстрат бир нече кайра иштетүү аркылуу өндүрүлгөн. Негизги процесс төмөнкүлөрдү камтыйт:
Чийки зат синтези: Жогорку тазалыктагы кремний порошок + тонер формулага ылайык аралаштырылат жана реакция 2000°Cден жогору жогорку температура шартында реакция камерасында белгилүү кристалл түрү жана бөлүкчөлөрдүн өлчөмү менен кремний карбидинин бөлүкчөлөрүн синтездөө үчүн жүргүзүлөт. Андан кийин майдалоо, тандоо, тазалоо жана башка процесстер аркылуу, жогорку тазалыктагы кремний карбиди порошок чийки заттын талаптарына жооп берет.
Кристаллдын өсүшү кремний карбидинин субстраттын электрдик касиеттерин аныктаган кремний карбидинин субстратын өндүрүүнүн негизги процесси болуп саналат. Азыркы учурда, кристалл өстүрүүнүн негизги ыкмалары болуп физикалык буу өткөрүп берүү (PVT), жогорку температурадагы химиялык бууларды түшүрүү (HT-CVD) жана суюк фазадагы эпитаксия (LPE) болуп саналат. Алардын ичинен PVT ыкмасы азыркы учурда SiC субстраттын коммерциялык өсүшүнүн негизги ыкмасы болуп саналат, техникалык жактан эң жогорку жетилген жана инженерияда кеңири колдонулат.

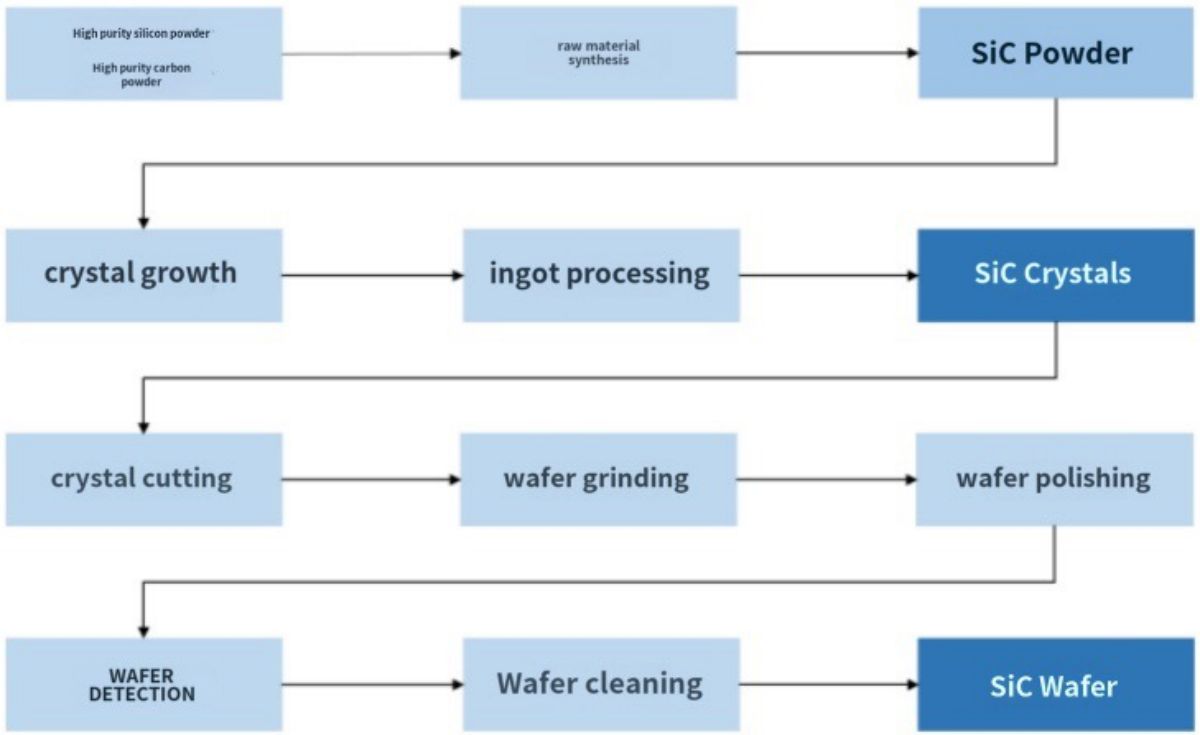
SiC субстратын даярдоо кыйын, бул анын жогорку баасына алып келет
Температура талаасын көзөмөлдөө кыйын: Si кристалл таякчасынын өсүшү 1500 ℃ гана керек, ал эми SiC кристалл таякчасы 2000 ℃ден жогору жогорку температурада өстүрүлүшү керек жана 250дөн ашык SiC изомерлери бар, бирок электр шаймандарын өндүрүү үчүн негизги 4H-SiC монокристалл структурасы, эгерде башка так контролдоо болбосо. Мындан тышкары, тигельдеги температура градиенти SiC сублимациясынын өтүү ылдамдыгын жана кристаллдын интерфейсинде газ түрүндөгү атомдордун жайгашуусун жана өсүү режимин аныктайт, бул кристаллдын өсүү ылдамдыгына жана кристаллдын сапатына таасирин тийгизет, ошондуктан температура талаасын системалуу башкаруу технологиясын түзүү зарыл. Si материалдары менен салыштырганда, SiC өндүрүшүндөгү айырма, ошондой эле жогорку температурадагы иондорду имплантациялоо, жогорку температурадагы кычкылдануу, жогорку температураны активдештирүү жана бул жогорку температура процесстери талап кылган катуу маска процесси сыяктуу жогорку температуралык процесстерде.
Жай кристаллдык өсүш: Si кристалл таякчасынын өсүү темпи 30 ~ 150мм / ч жетиши мүмкүн, ал эми 1-3м кремний кристалл таякчасын өндүрүү 1 күндү гана талап кылат; Мисал катары PVT ыкмасы менен SiC кристалл таяк, өсүү темпи болжол менен 0.2-0.4mm / ч, 7 күн 3-6cm кем өсөт, өсүү темпи кремний материалдын 1% дан аз эмес, өндүрүш кубаттуулугу өтө чектелген.
Продукциянын жогорку параметрлери жана аз кирешелүүлүгү: SiC субстратынын негизги параметрлери микротюбдук тыгыздыкты, дислокациянын тыгыздыгын, каршылыкты, бузулууларды, беттик тегиздикти жана башкалар.
Материал жогорку катуулук, жогорку морттук, узун кесүү убактысы жана жогорку эскирүүгө ээ: SiC Mohs катуулугу 9,25 алмаздан кийинки экинчи орунда турат, бул кесүү, майдалоо жана жылмалоо кыйынчылыгынын олуттуу өсүшүнө алып келет жана калыңдыгы 3 см куймадан 35-40 даана кесүү үчүн болжол менен 120 саат талап кылынат. Мындан тышкары, SiC жогорку морттугуна байланыштуу, пластина иштетүү эскирүү көбүрөөк болот, жана өндүрүштүк катышы гана 60% түзөт.
Өнүгүү тенденциясы: Өлчөмдүн өсүшү + баанын төмөндөшү
Дүйнөлүк SiC рыногу 6 дюймдук көлөмдөгү өндүрүш линиясы жетилип, алдыңкы компаниялар 8 дюймдук рынокко кирди. Ички өнүктүрүү долбоорлору негизинен 6 дюйм. Азыркы учурда, ата мекендик компаниялардын көпчүлүгү дагы эле 4 дюймдук өндүрүш линияларына негизделсе да, өнөр жай акырындык менен 6 дюймга чейин кеңейип жатат, 6 дюймдук колдоочу жабдуулардын технологиясы жетилгендиктен, ата мекендик SiC субстрат технологиясы да акырындык менен чоң көлөмдөгү өндүрүш линияларынын масштабынын экономикасын жакшыртат. Чоңураак пластинка өлчөмү бир микросхемалардын санын көбөйтүп, кирешелүүлүгүн жакшыртып, четки чиптердин үлүшүн азайтышы мүмкүн жана изилдөө жана иштеп чыгуунун баасы жана түшүмдүүлүктүн жоголушу болжол менен 7% деңгээлинде сакталат, ошону менен пластинаны пайдаланууну жакшыртат.
Аппаратты иштеп чыгууда дагы эле көп кыйынчылыктар бар
SiC диодунун коммерциализациясы акырындык менен жакшыртылып жатат, азыркы учурда бир катар ата мекендик өндүрүүчүлөр SiC SBD продуктуларын иштеп чыгышты, орто жана жогорку чыңалуудагы SiC SBD өнүмдөрү жакшы туруктуулукка ээ, OBC унаасында, SiC SBD+SI IGBT колдонуу туруктуу токтун тыгыздыгына жетишүү үчүн. Учурда Кытайда SiC SBD продукциясынын патенттик дизайнында эч кандай тоскоолдуктар жок жана чет мамлекеттер менен айырма аз.
SiC MOS дагы эле көптөгөн кыйынчылыктарга ээ, SiC MOS менен чет өлкөлүк өндүрүүчүлөрдүн ортосунда дагы эле ажырым бар жана тиешелүү өндүрүш платформасы дагы эле курулуп жатат. Азыркы учурда, ST, Infineon, Rohm жана башка 600-1700V SiC MOS массалык өндүрүшкө жетишти жана көптөгөн өндүрүш тармактары менен кол коюшту жана жөнөтүлдү, ал эми учурдагы ички SiC MOS дизайны негизинен аяктады, бир катар дизайн өндүрүүчүлөр пластинка агымынын баскычында фабтар менен иштеп жатышат, жана кийинчерээк кардарларды коммерциялык текшерүү дагы бир аз убакытты талап кылат.
Азыркы учурда, тегиздик структурасы негизги тандоо болуп саналат, ал эми траншея түрү келечекте көп басымдуу талаада колдонулат. Planar түзүмү SiC MOS өндүрүүчүлөр көп, тегиздик структурасы 1200V төмөн рынокто 1200V төмөн колдонуу наркынын кенен спектри бар, оюк менен салыштырганда локалдык бузулуу көйгөйлөрүн өндүрүү үчүн жеңил эмес, жана тегиздик структурасы өндүрүштүн акырына карата салыштырмалуу жөнөкөй болуп саналат, өндүрүш жана чыгымдарды көзөмөлдөө эки аспектилерин канааттандыруу үчүн. Groove аппараты өтө төмөн мите индуктивдүүлүктүн, тез которулуу ылдамдыгынын, аз жоготуулардын жана салыштырмалуу жогорку көрсөткүчтөрдүн артыкчылыктарына ээ.
2--SiC вафли жаңылыктары
Кремний карбид рыногун өндүрүү жана сатуунун өсүшү, суроо-талап менен сунуштун ортосундагы түзүмдүк дисбаланс кулак салгыла


Рыноктун жогорку жыштыктагы жана жогорку кубаттуулуктагы электроникага болгон суроо-талаптын тез өсүшү менен, кремний негизиндеги жарым өткөргүч түзүлүштөрдүн физикалык чектөөлөрүнүн тардыгы бара-бара көрүнүктүү болуп калды, ал эми кремний карбиди (SiC) менен көрсөтүлгөн үчүнчү муундагы жарым өткөргүч материалдар акырындык менен өнөр жайга айланды. Материалдык натыйжалуулук жагынан алганда, кремний карбиди кремний материалынын тилкесинин кеңдигинен 3 эсе, электр талаасынын критикалык күчү 10 эсе, жылуулук өткөрүмдүүлүк 3 эсе көп, ошондуктан кремний карбидинин электр шаймандары жогорку жыштык, жогорку басым, жогорку температура жана башка колдонмолор үчүн ылайыктуу.
Азыркы учурда, SiC диоддор жана SiC MOSFETs акырындык менен рынокко көчүп, дагы жетилген продуктылар бар, алардын арасында SiC диоддор тескери калыбына келтирүү заряддын артыкчылыгы жок, анткени кээ бир тармактарда кремний негизделген диоддордун ордуна көп колдонулат; SiC MOSFET да бара-бара унаа, энергия сактоо, кубаттоо үйүлгөн, photovoltaic жана башка тармактарда колдонулат; Автомобилдик тиркемелер тармагында модулизациялоо тенденциясы барган сайын көрүнүктүү болуп баратат, SiCтин жогорку көрсөткүчтөрүн жетүү үчүн алдыңкы таңгактоо процесстерине таянуу керек, техникалык жактан салыштырмалуу жетилген кабык мөөр менен негизги агым катары, келечекте же пластикалык пломбаны өнүктүрүү, анын ылайыкташтырылган өнүктүрүү мүнөздөмөлөрү SiC модулдары үчүн көбүрөөк ылайыктуу.
Кремний карбидинин баасынын төмөндөшү ылдамдыгы же кыялдануу

Кремний карбидинин түзүлүштөрүн колдонуу негизинен жогорку наркы менен чектелет, ошол эле деңгээлдеги SiC MOSFETтин баасы Si негизиндеги IGBTге караганда 4 эсе жогору, анткени кремний карбидинин процесси татаал, анда монокристаллдын жана эпитаксиалдын өсүшү айлана-чөйрөгө катаал гана эмес, өсүү темпи жай жана субстратты кесүү процессине өтүшү керек. Өзүнүн материалдык өзгөчөлүктөрүнө жана жетиле элек кайра иштетүү технологиясына таянсак, ата мекендик субстраттын түшүмү 50% дан кем эмес, ар кандай факторлор субстраттын жана эпитаксиалдык баанын жогору болушуна алып келет.
Бирок, кремний карбид аппараттарынын жана кремний негизиндеги аппараттардын наркынын курамы таптакыр карама-каршы келет, алдыңкы каналдын субстраттык жана эпитаксиалдык чыгымдары бүт аппараттын 47% жана 23% түзөт, жалпысынан 70% түзөт, арткы каналдын түзүлүшүнүн конструкциясы, өндүрүшү жана мөөр басылышы 30% гана түзөт, кремнийдин негизиндеги аппараттардын өндүрүшүнүн негизги наркы 30% түзөт. арткы каналды өндүрүү болжол менен 50%, ал эми субстрат наркы 7% гана түзөт. Кремний карбидинин өнөр жай чынжырынын наркынын көрүнүшү өйдө жактагы субстрат epitaxy өндүрүүчүлөрүнүн ата мекендик жана чет элдик ишканалардын макетинин ачкычы болгон негизги укукка ээ экендигин билдирет.
Рыноктун динамикалык көз карашынан алганда, кремний карбидинин наркын төмөндөтүү, кремний карбидинин узун кристалын жана кесүү процессин жакшыртуудан тышкары, пластинанын өлчөмүн кеңейтүү болуп саналат, бул да өткөндө жарым өткөргүчтүн өнүгүү жолу болуп саналат, Wolfspeed маалыматтары кремний карбидинин өндүрүшүн 6 чиптен субстраттын модернизациясын көбөйтө аларын көрсөтүп турат. 80%-90% жана түшүмдүүлүктү жогорулатууга жардам берет. Бирдиктин наркын 50% га төмөндөтө алат.
2023-жыл "8 дюймдук SiC биринчи жылы" деп аталат, бул жылы ата мекендик жана чет өлкөлүк кремний карбид өндүрүүчүлөрү 8 дюймдук кремний карбидинин схемасын тездетип жатышат, мисалы Wolfspeed жинди инвестициясы кремний карбидин өндүрүүнү кеңейтүү үчүн 14,55 миллиард АКШ долларын түзөт, анын маанилүү бөлүгү SiC 8 дюймдук кремний карбидинин курулушун камсыз кылат Бир катар ишканаларга 200 мм SiC жылаңач металл; Ата мекендик Tianyue Advanced жана Tianke Heda да келечекте 8 дюймдук кремний карбид субстраттарын жеткирүү боюнча Infineon менен узак мөөнөттүү келишимдерге кол коюшту.
Ушул жылдан баштап кремний карбиди 6 дюймдан 8 дюймга чейин тездейт, Wolfspeed 2024-жылга карата 8 дюймдук субстраттын чип бирдигинин баасы 2022-жылы 6 дюймдук субстраттын бирдигинин чипинин наркына салыштырмалуу 60% дан ашык төмөндөйт деп күтөт, ал эми чыгымдардын төмөндөшү колдонмонун рыногун андан ары ачат. 8 дюймдук буюмдардын учурдагы рыноктук үлүшү 2% дан аз, ал эми рыноктун үлүшү 2026-жылга чейин болжол менен 15% га чейин өсөт деп күтүлүүдө.
Чынында, кремний карбидинин субстратынын баасынын төмөндөшүнүн ылдамдыгы көптөгөн адамдардын кыялынан ашып кетиши мүмкүн, 6 дюймдук субстраттын учурдагы базар сунушу 4000-5000 юань / даана, жыл башына салыштырмалуу бир топ төмөндөдү, келерки жылы 4000 юандан төмөн түшүшү күтүлөт. ылдыйда, негизинен кремний карбид субстрат менен камсыз кылуу топтолгон баа согуш моделин ачты, төмөн чыңалуу тармагында салыштырмалуу жетиштүү болду, ата мекендик жана чет өлкөлүк өндүрүүчүлөр агрессивдүү өндүрүштүк мүмкүнчүлүктөрүн кеңейтип жатат, же кремний карбид субстрат ашыкча этабында элестеткенден эртерээк болсун.
Посттун убактысы: 19-январь-2024
